현재 패키징 업계는 변곡점에 와 있다. 단일 실리콘 인터포저 상에 백만 개의 I/O가 연결될 정도로 밀도가 점점 더 높아지고 있고, 웨이퍼 팹에서 회선 선폭 축소가 계속 이어지듯 인터커넥트도 축소되기 시작했다. 적층은 도처에서 진행되고 있다. 디바이스 자체에서, 패키지 레이어들 사이에서, 그리고 PCB 내부에서도 일어난다. 이러한 요인들 때문에 이제는 한 곳에서 불량이 발생하면, 결함을 격리하고 분석하기가 예전보다 훨씬 더 어려워졌다.
자이스(ZEISS)는 반도체 패키지 불량 분석 솔루션 FIB-SEM(focused ion beam-scanning electron microscope) 신제품 자이스 크로스빔 레이저(ZEISS Crossbeam Laser)를 출시한다고 5일 밝혔다.
자이스 크로스빔 레이저는 첨단 반도체 패키지 작업의 패키지 불량 분석(FA) 및 공정 최적화 속도를 종전보다 수십 배 향상시킨다. 빠른 속도 구현에 펨토세컨드 레이저, 정확도를 높이기 위해 갈륨이온(Ga+) 빔, 나노급 해상도 이미징을 위해 SEM을 통합한 자이스 크로스빔 레이저 제품군은 패키지 엔지니어와 불량 분석 작업자들에게 고속의 이미징 성능으로 가장 빠른 단면 분석으로 샘플 손상을 최소화한다.
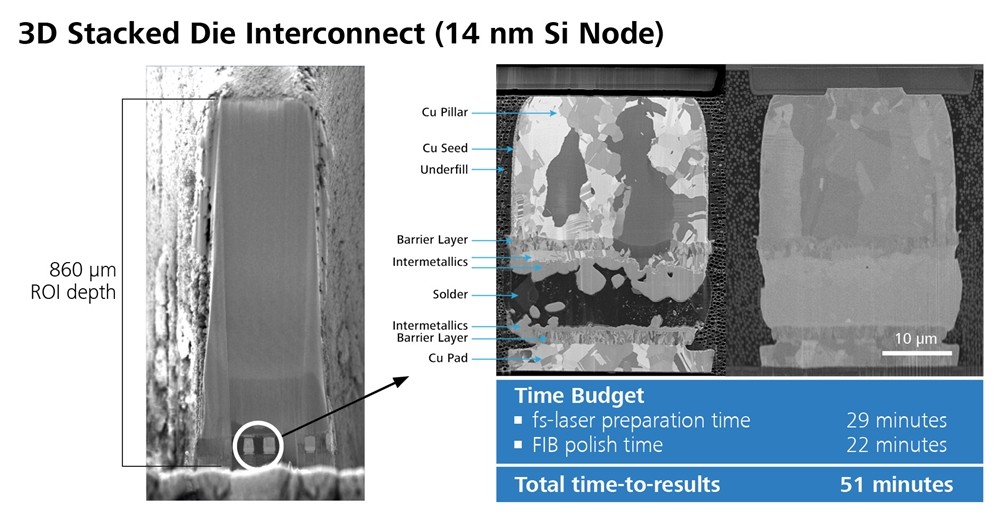
자이스 크로스빔 레이저 제품군은 코퍼 필라(Cu-pillar) 솔더 범프와 TSV(through silicon via) 같이 깊숙이 매립된 패키지 인터커넥트는 물론, 디바이스 BEOL(back-end-of-line)과 FEOL(front-end-of-line) 구조의 단면 확인에 걸리는 시간을 타사 장비 혹은 분석 기술 사용시 수 시간에서 수 일까지 걸리던 것을 불과 수 분 정도로 획기적으로 단축한다. 진공 상태에서 아티팩트를 최소화하고 샘플 품질도 일관성 있게 유지한다.
불량 분석 외에도 구조적 분석(SA), 구조 분석(CA), 리버스 엔지니어링, FIB Tomography 및 투과전자현미경(transmission electron microscopy, TEM) 샘플 준비 등에 활용할 수 있다.
자이스 공정제어솔루션(PCS) 및 칼 자이스 SMT(Carl Zeiss) 라즈 자미(Raj Jammy) 사장은 ”자이스 크로스빔 레이저 제품군은 FA 엔지니어가 감당해야 하는 이러한 압박들을 경감해 줄 수 있도록 설계되었으며, 속도와 정확성 그리고 고해상 이미징 특성을 모두 하나의 장비에 통합한 최상의 접근법을 통해 결과 도출 시간을 획기적으로 단축했다”고 자신했다.
이향선기자 hslee@nextdaily.co.kr

